Будьте завжди в курсі!
Дізнавайтесь про новітні розробки першими
Новини
Всі новини
Статті
14.12.2020
BGA, CSP, DBS, PLCC, SOIC та інші корпуси ІС
За останні десятиліття компаніями виробниками напівпровідників було розроблено безліч корпусів для інтегральних схем. Тож тепер давайте більш детально подивимось на найбільш поширені з них:
BGA (Ball Grid Array)
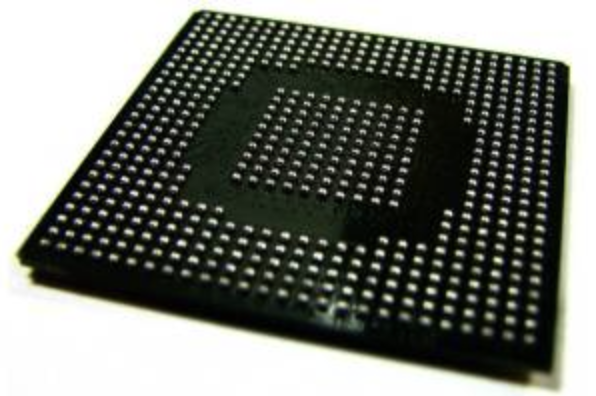
Корпус BGA походить від корпусу PGA (опис далі). Призначений для поверхневого монтажу. BGA виводи (від Ball grid array - масив кульок) являють собою кульки припою, нанесені на контактні площадки зі зворотного боку мікросхеми. Мікросхему розташовують на друкованій платі згідно з маркуванням першого контакту. Далі мікросхему нагрівають так, що кульки починають плавитись. Поверхневий натяг змушує розплавлений припій зафіксувати мікросхему над тим місцем, де вона повинна знаходитись на платі. Поєднання певного припою, температури паяння, флюсу і паяльної маски не дозволяє кулькам повністю деформуватись. Частіше всього використовується для виготовлення мобільних процесорів, чіпсетів і сучасних графічних процесорів. В залежності від матеріалу корпусу виділяють три варіанти виконання:
Наприклад:
CSP (Chip-scale Package or Chip Scale Package)

Корпус CSP це наступний за корпусом BGA крок у напрямку мініатюризації корпусів мікросхем. У відповідності зі стандартом J-STD-012, для того щоб кваліфікуватися як CSP, корпус повинен перевищувати площу кристалу не більше ніж в 1,2 рази. Таким чином, корпус має розмір, який лише трохи більший розміру кристалу, тобто форм-фактор складає близько 1,2.
Корпуси CSP можна розділити на такі групи:

Корпус DBS використовується для мікросхем підвищеної потужності, які потребують використання тепловідводу

Корпус прямокутної форми з двома рядами штирових виводів по довгим вузьким сторонам для монтажу в отвори у друкованій платі.
Корпус DIP може бути:
У позначенні корпусу вказується число виводів: DIP8, DIP14, DIP16 і подібне.

Низькопрофільний квадратний керамічний корпус з розміщеними по чотирьох сторонах на його нижній частині пласкими виводами, що призначені для поверхневого монтажу.

Являє собою корпус PGA, у якому виводи у вигляді штирів замінені на контактні площадки. Може встановлюватися у спеціальне гніздо, що має пружинні контакти, або встановлюватись шляхом паянням матриці контактних площадок безпосередньо на друковану плату. У залежності від матеріалу корпусу виділяють три варіанти виконання:

Квадратний або прямокутний корпус з матрицею виводів, які розміщуються по чотирьох сторонах корпусу. Виводи у вигляді штирів для запаювання в отвори у друкованій платі розміщені на його нижній частині. У сучасних процесорах виводи розміщуються у шахматному порядку. В залежності від матеріалу корпусу виділяють три варіанти виконання:

Квадратні корпуси з розташованими по краях по чотирьох сторонах загнутими виводами, що призначені для встановлення у спеціальну панель (PLCC панель). При цьому корпус допускає використання і для поверхневого монтажу. Назва різна в залежності від матеріалу, з якого виготовлено корпус:
Масове розповсюдження свого часу отримали мікросхеми флеш-пам'яті у корпусі PLCC, що використовуються у якості мікросхеми BIOS на системних платах.

За розмірами близькі до корпусів CSP, але на відміну від них мають планарні виводи, що розташовані безпосередньо під мікросхемою по всім чотирьом (QFN) або двом (DFN або SON) сторонам. Корпус має квадратну або прямокутну форму, його розміри визначається кількістю виводів. По центру мікросхеми є площадка для припаювання до друкованої плати з метою відводу тепла, а також додаткового контакту з землею. Мікросхеми в таких корпусах призначені тільки для поверхневого монтажу; установка в перехідну панель або монтаж в отвори плати штатно не передбачений, хоча перехідні панелі для них існують. Крок між виводами: 1,0, 0,8, 0,65, 0,5, 0,4 або 0,35 мм.
Різні виробники використовують для таких корпусів різні назви:

Плаский квадратний або прямокутний корпус з планарними зігнутими назовні виводами, що розташовані по краях всіх чотирьох сторін. Виводи призначені тільки для поверхневого монтажу. Корпус має багато різновидів, які різняться числом виводів, кроком, розмірами і використаними матеріалами, при цьому корпус BQFP відрізняється розширеннями основи по кутам мікросхеми, що призначені для захисту виводів від механічних пошкоджень до запаювання:

Спеціальний плаский прямокутний корпус для горизонтального монтажу в отвори друкованої плати, з одним рядом штирових виводів по довгій вузькій стороні. Використовується у потужних мікросхемах, що потребують кріплення до додаткового тепловідводу.

Плаский прямокутний корпус для вертикального монтажу в отвори друкованої плати, з одним рядом штирових виводів по довгій вузькій стороні. У позначенні корпусу вказується число виводів: SIP7, SIP8, SIP9 і подібне.

Корпус має досить тонку прямокутну форму, що нагадує корпус DIP, але призначений для поверхневого монтажу. Виводи, вигнути назовні, розташовані по двом довгим сторонам і припаюються з того ж боку друкованої плати, де розміщається корпус. У позначенні корпусу вказується число виводів: SOIC8, SOIC12, SOIC16.

Плаский корпус для вертикального монтажу в отвори друкованої плати з штировими виводами, що розташовані зигзагоподібно по довгій вузькій стороні двома рядами у шахматному порядку.
За останні десятиліття компаніями виробниками напівпровідників було розроблено безліч корпусів для інтегральних схем. Тож тепер давайте більш детально подивимось на найбільш поширені з них:
BGA (Ball Grid Array)
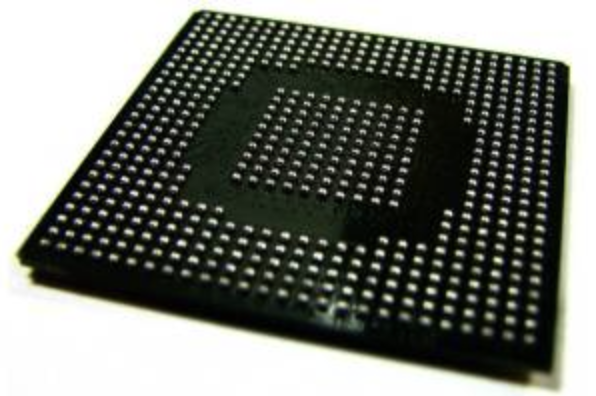
Корпус BGA походить від корпусу PGA (опис далі). Призначений для поверхневого монтажу. BGA виводи (від Ball grid array - масив кульок) являють собою кульки припою, нанесені на контактні площадки зі зворотного боку мікросхеми. Мікросхему розташовують на друкованій платі згідно з маркуванням першого контакту. Далі мікросхему нагрівають так, що кульки починають плавитись. Поверхневий натяг змушує розплавлений припій зафіксувати мікросхему над тим місцем, де вона повинна знаходитись на платі. Поєднання певного припою, температури паяння, флюсу і паяльної маски не дозволяє кулькам повністю деформуватись. Частіше всього використовується для виготовлення мобільних процесорів, чіпсетів і сучасних графічних процесорів. В залежності від матеріалу корпусу виділяють три варіанти виконання:
- CBGA (Ceramic BGA, Ceramic Ball Grid Array) - з кераміки;
- PBGA (Plastic BGA, Plastic Ball Grid Array) - з пластику;
- TBGA (Tape BGA, Tape Ball Grid Array) – з поліімідною плівкою у основі.
- CBGA (Ceramic BGA, Ceramic Ball Grid Array) - з кераміки з кульковими виводами;
- CCGA (Ceramic CGA, Ceramic Column Grid Array) - з кераміки з стовпчиковими виводами.
- BGA (Ball Grid Array) - стандартний;
- MBGA (Micro BGA, Micro Ball Grid Array) - близький до розміру кристалу.
- BGA (Ball Grid Array) - стандартний;
- LBGA (Low-Profile BGA, Low-Profile Ball Grid Array) - низькопрофільний у частини виробників;
- LPBGA (Low Profile BGA, Low Profile Ball Grid Array) - низькопрофільний у частини виробників;
- TBGA (Thick BGA, Thick Ball Grid Array) - високий у частини виробників;
- TBGA (Thin BGA, Thin Ball Grid Array) - тонкий у частини виробників;
- UTBGA (Ultra Thin BGA, Ultra Thin Ball Grid Array) - ультратонкий;
- VTBGA (Very Thick BGA, Very Thick Ball Grid Array) - дуже високий у частини виробників;
- VTBGA (Very Thin BGA, Very Thin Ball Grid Array) - дуже тонкий у частини виробників;
- VVTBGA (Very Very Thin BGA, Very Very Thin Ball Grid Array) - дуже дуже тонкий.
- BGA (Ball Grid Array) - стандартний;
- FPBGA (Fine Pitch BGA, Fine Pitch Ball Grid Array) - з дрібним кроком виводів.
Наприклад:
- LFBGA (Low-profile Fine-pitch Ball Grid Array) - низькопрофільний з дрібним кроком, і таке інше.
- CABGA (Chip Array Ball Grid Array);
- CDBGA (Cavity-Down Ball Grid Array);
- D2BGA (Die Dimension Ball Grid Array);
- ESBGA (Enhanced Super Ball-Grid Array);
- EPBGA (Enhanced Plastic Ball Grid Array);
- FC-BGA (Flip-Chip Ball Grid Array);
- FCBGA (Flip Chip Ball Grid Array);
- FPBGA (Fine-Pitch Ball Grid Array);
- HSBGA (Heat Slug Ball Grid Array);
- L2BGA (Laser Laminated Ball Grid Array);
- LPBGA (Low-Profile Ball Grid Array);
- MCBGA (Multi-Chip Ball Grid Array);
- SDBGA (Super Dissipation Ball Grid Array);
- SSBGA (Small Scale Ball Grid Array);
- TEBGA (Thermally Enhanced Ball Grid Array);
- CSBGA (Chip Scale Ball Grid Array);
- BATEL (Ball grid array Technologies for advanced Telecom applications);
- BGAI (Ball Grid Array Illustration);
- SDBGA (Stacked Die Ball Grid Array Read) тощо.
CSP (Chip-scale Package or Chip Scale Package)

Корпус CSP це наступний за корпусом BGA крок у напрямку мініатюризації корпусів мікросхем. У відповідності зі стандартом J-STD-012, для того щоб кваліфікуватися як CSP, корпус повинен перевищувати площу кристалу не більше ніж в 1,2 рази. Таким чином, корпус має розмір, який лише трохи більший розміру кристалу, тобто форм-фактор складає близько 1,2.
Корпуси CSP можна розділити на такі групи:
- FCCSP (Flip-chip CSP) - змонтований методом перевернутого кристалу;
- Flexible substrate-based CSP - виготовлений на основі гнучких підкладок;
- LFCSP (Customized leadframe-based CSP) - виготовлений на основі різних вивідних рамок;
- Rigid substrate-based CSP - виготовлений на основі жорстких підкладок
- WL-CSP (Wafer-level redistribution CSP) - з контактними кульками, що протравлені або надруковані безпосередньо на кремнієвій підкладці.
DBS (DIL Bent SIL, Dual In-Line Bent Single In-Line)

Корпус DBS використовується для мікросхем підвищеної потужності, які потребують використання тепловідводу
DIP (DIL) (Dual In-line Package) він же DIPP (Dual In-line Pin Package)

Корпус прямокутної форми з двома рядами штирових виводів по довгим вузьким сторонам для монтажу в отвори у друкованій платі.
Корпус DIP може бути:
- CerDIP або CDIP (Ceramic DIP, Ceramic Dual In-line Package) - з кераміки;
- FDIP (Windowed Frit-Seal DIP, Windowed Frit-Seal Dual In-line Package) - з віконечком для запису;
- HDIP (Heat-dissipating DIP, Heat-dissipating Dual In-line Package) - теплорозсіюючий;
- MDIP (Molded DIP, Molded Dual In-line Package) - формований;
- PDIP (Plastic DIP, Plastic Dual In-line Package) - з пластику;
- SPDIP (Shrink Plastic DIP, Shrink Plastic Dual In-line Package) - стиснутий пластиковий;
- SDIP (Skinny DIP, Skinny Dual In-line Package) - тонкий.
У позначенні корпусу вказується число виводів: DIP8, DIP14, DIP16 і подібне.
LCC (Leadless Chip Carrier)

Низькопрофільний квадратний керамічний корпус з розміщеними по чотирьох сторонах на його нижній частині пласкими виводами, що призначені для поверхневого монтажу.
LGA (Land Grid Array)

Являє собою корпус PGA, у якому виводи у вигляді штирів замінені на контактні площадки. Може встановлюватися у спеціальне гніздо, що має пружинні контакти, або встановлюватись шляхом паянням матриці контактних площадок безпосередньо на друковану плату. У залежності від матеріалу корпусу виділяють три варіанти виконання:
- CLGA (Ceramic LGA, Ceramic Land Grid Array) - з кераміки;
- OLGA (Organic LGA, Organic Land Grid Array) - з органічного матеріалу;
- PLGA (Plastic LGA, Plastic Land Grid Array) - з пластику.
- FCLGA (Flip-Chip LGA, Flip-Chip Land Grid Array) - з перевернутим кристалом;
- FCLGA2 (Flip-Chip LGA 2, Flip-Chip Land Grid Array 2) - з перевернутим кристалом, як FCLGA, і додатково з теплорозподільником.
PGA (Pin Grid Array)

Квадратний або прямокутний корпус з матрицею виводів, які розміщуються по чотирьох сторонах корпусу. Виводи у вигляді штирів для запаювання в отвори у друкованій платі розміщені на його нижній частині. У сучасних процесорах виводи розміщуються у шахматному порядку. В залежності від матеріалу корпусу виділяють три варіанти виконання:
- CPGA (Ceramic PGA, Ceramic Pin Grid Array) - з кераміки;
- OPGA (Organic PGA, Organic Pin Grid Array) - з органічного матеріалу;
- PPGA (Plastic PGA, Plastic Pin Grid Array) - з пластику.
- FCPGA (Flip-Chip PGA, Flip-Chip Pin Grid Array) - з перевернутим кристалом;
- FCPGA2 (Flip-Chip PGA 2, Flip-Chip Pin Grid Array 2) - з перевернутим кристалом, як FCPGA, і додатково з теплорозподільником;
- mFCPGA (Micro Flip-Chip PGA, Micro Flip-Chip Pin Grid Array) - компактний варіант корпусу FCPGA;
- mPGA (Micro PGA, Micro Pin Grid Array) - компактний варіант корпусу FCPGA2.
PLCC (Plastic Leaded Chip Carrier) та СLCC (Ceramic Leaded Chip Carrier)

Квадратні корпуси з розташованими по краях по чотирьох сторонах загнутими виводами, що призначені для встановлення у спеціальну панель (PLCC панель). При цьому корпус допускає використання і для поверхневого монтажу. Назва різна в залежності від матеріалу, з якого виготовлено корпус:
- CLCC (Ceramic Leaded Chip Carrier) - з кераміки;
- PLCC (Plastic Leaded Chip Carrier) - з пластику.
Масове розповсюдження свого часу отримали мікросхеми флеш-пам'яті у корпусі PLCC, що використовуються у якості мікросхеми BIOS на системних платах.
QFN (Quad Flat No-leads package) та DFN (Dual Flat No-leads package) або SON (Small Outline package)

За розмірами близькі до корпусів CSP, але на відміну від них мають планарні виводи, що розташовані безпосередньо під мікросхемою по всім чотирьом (QFN) або двом (DFN або SON) сторонам. Корпус має квадратну або прямокутну форму, його розміри визначається кількістю виводів. По центру мікросхеми є площадка для припаювання до друкованої плати з метою відводу тепла, а також додаткового контакту з землею. Мікросхеми в таких корпусах призначені тільки для поверхневого монтажу; установка в перехідну панель або монтаж в отвори плати штатно не передбачений, хоча перехідні панелі для них існують. Крок між виводами: 1,0, 0,8, 0,65, 0,5, 0,4 або 0,35 мм.
Різні виробники використовують для таких корпусів різні назви:
- cDFN
- DHVQFN (Depopulated Heatsink Very-thin Quad Flat-pack)
- DHXQFN (Depopulated Heatsink eXtremely-thin Quad Flat-pack)
- DQFN (Depopulated Very-Thin Quad Flat-Pack No-Leads)
- DRMLF (Dual Row MicroLeadFrame package)
- HUQFN (Heatsink Ultra-thin Quad Flat-pack)
- HVQFN (Heatsink Very-thin Quad Flat-pack)
- HVSON (Heatsink Very-thin Small Outline package)
- HWQFN (Heatsink Very-Very-thin Quad Flat-pack)
- HWSON (Heatsink Very-Very-thin Small Outline package)
- HXQFN (Heatsink eXtremely-thin Quad Flat-pack)
- HXSON (Heatsink eXtremely Small Outline package)
- LLP (Leadless Leadframe Package)
- LPCC (Leadless Plastic Chip Carrier)
- MLF (Micro-LeadFrame)
- MLPD (Micro-Leadframe Package Dual)
- MLPM (Micro-Leadframe Package Micro)
- MLPQ (Micro-Leadframe Package Quad)
- QFN-TEP (Quad Flat No-lead package with Top-Exposed Pad)
- TDFN (Thin Dual Flat No-lead package)
- TQFN (Thin Quad Flat No-lead package)
- UQFN (Ultrathin Quad Flat No-lead)
- UTDFN (Ultra-Thin Dual Flat No-lead package)
- VQFN (Very Thin quad Flat No-lead)
- XDFN (eXtremely thin Dual Flat No-lead package)
QFP (Quad Flat Package)

Плаский квадратний або прямокутний корпус з планарними зігнутими назовні виводами, що розташовані по краях всіх чотирьох сторін. Виводи призначені тільки для поверхневого монтажу. Корпус має багато різновидів, які різняться числом виводів, кроком, розмірами і використаними матеріалами, при цьому корпус BQFP відрізняється розширеннями основи по кутам мікросхеми, що призначені для захисту виводів від механічних пошкоджень до запаювання:
- BQFP (Bumpered QFP, Bumpered Quad Flat Package) - з розширеннями основи по кутам корпусу;
- BQFPH (Bumpered QFP with Heat spreader, Bumpered Quad Flat Package with Heat spreader) - з розширеннями основи по кутам корпусу та теплорозподільником;
- CQFP (Ceramic QFP, Ceramic Quad Flat Package) - з кераміки;
- FQFP (Fine Pitch QFP, Fine Pitch Quad Flat Package) - з дрібним кроком виводів;
- HQFP (Heat sinked QFP, Heat sinked Quad Flat Package) - з тепловідводом;
- LQFP (Low Profile QFP, Low Profile Quad Flat Package) - низькопрофільний;
- MQFP (Metric QFP, Metric Quad Flat Package) - з метричним кроком виводів;
- PQFP (Plastic QFP, Plastic Quad Flat Package) - з пластику;
- SQFP (Shrink QFP, Shrink Quad Flat Package) - стиснутий;
- SQFP (Small QFP, Small Quad Flat Package) - маленького розміру;
- TQFP (Thin QFP, Thin Quad Flat Package) - тонкий;
- VQFP (Very small QFP, Very small Quad Flat Package) - дуже маленького розміру;
- VTQFP (Very Thin QFP, Very Thin Quad Flat Package) - дуже тонкий.
RBS (Rectangular-Bent Single in-line package)

Спеціальний плаский прямокутний корпус для горизонтального монтажу в отвори друкованої плати, з одним рядом штирових виводів по довгій вузькій стороні. Використовується у потужних мікросхемах, що потребують кріплення до додаткового тепловідводу.
SIP (SIL) (Single In-line Package)

Плаский прямокутний корпус для вертикального монтажу в отвори друкованої плати, з одним рядом штирових виводів по довгій вузькій стороні. У позначенні корпусу вказується число виводів: SIP7, SIP8, SIP9 і подібне.
SOIC (SO) (Small-Outline Integrated Circuit) він же SOP (Small-Outline Package)

Корпус має досить тонку прямокутну форму, що нагадує корпус DIP, але призначений для поверхневого монтажу. Виводи, вигнути назовні, розташовані по двом довгим сторонам і припаюються з того ж боку друкованої плати, де розміщається корпус. У позначенні корпусу вказується число виводів: SOIC8, SOIC12, SOIC16.
- CSOP (Ceramic SOP, Ceramic Small-Outline Package) - з кераміки;
- HSOP (Heat Sink SOP, Heat Sink Small-Outline Package) - з тепловідводом;
- HSSOP (Heat Sink Shrink SOP, Heat Sink Shrink Small-Outline Package) - малогабаритний з тепловідводом;
- HTSSOP (Heat Sink Thin Shrink SOP, Heat Sink Thin Shrink Small-Outline Package) - тонкий з тепловідводом;
- µSOP (Micro SOP, Micro Small Outline Package) - дуже зменшеного розміру;
- MSOP (Mini SOP, Mini Small-Outline Package) - зменшеного розміру;
- QSOP (Quarter SOP, Quarter Small-Outline Package) - квадратний;
- QSOP (Quarter Size SOP, Quarter Size Small-Outline Package) - квадратний;
- SSOP (Shrink SOP, Shrink Small-Outline Package) - стиснутий малогабаритний;
- TSOP (Thin SOP, Thin Small-Outline Package) - тонкий малогабаритний;
- TSSOP (Thin Shrink SOP, Thin Shrink Small-Outline Package) - надтонкий;
- VSOP (Very Small Outline Package) - мініатюрний.
ZIP (Zigzag-In-line Package)

Плаский корпус для вертикального монтажу в отвори друкованої плати з штировими виводами, що розташовані зигзагоподібно по довгій вузькій стороні двома рядами у шахматному порядку.













































